【导语】随着微电子系统需求向更强大、高效发展,3D集成技术成为业界焦点,通过将芯片堆叠实现高性(xìng)能(néng)处(chù)理(lǐ)器(qì)与(yǔ)专(zhuān)业(yè)芯(xīn)片(piàn)的(de)紧(jǐn)密(mì)封(fēng)装(zhuāng)。然(rán)而(ér),如(rú)何(hé)有(yǒu)效(xiào)散(sàn)热(rè)成(chéng)为(wèi)技(jì)术(shù)人(rén)员(yuán)面(miàn)临(lín)的(de)关键挑(tiāo)战(zhàn)。麻(má)省(shěng)理(lǐ)工(gōng)学(xué)院(yuàn)林(lín)肯(kěn)实(shí)验(yàn)室(shì)开(kāi)发(fā)出(chū)一(yī)种(zhǒng)专(zhuān)用(yòng)测(cè)试(shì)芯(xīn)片(piàn),旨(zhǐ)在(zài)验(yàn)证(zhèng)封(fēng)装(zhuāng)堆(duī)叠(dié)芯(xīn)片(piàn)的(de)冷(lěng)却(què)方(fāng)案(àn),目(mù)前(qián)正(zhèng)由(yóu)HRL Laboratories用(yòng)于(yú)3D异(yì)质(zhì)集成(chéng)系(xì)统(tǒng)的(de)冷(lěng)却(què)系(xì)统(tǒng)开(kāi)发(fā)。
驾趣智库讯(xùn) 随(suí)着(zhe)对(duì)更(gèng)强(qiáng)大(dà)、更(gèng)高(gāo)效(xiào)的(de)微(wēi)电(diàn)子(zi)系(xì)统(tǒng)的(de)需(xū)求(qiú)不(bù)断(duàn)增(zēng)长(zhǎng),业(yè)界(jiè)正(zhèng)转(zhuǎn)向(xiàng)3D集成(chéng)——将(jiāng)芯(xīn)片堆叠在一起。这种垂直分层架构可以将高性能处理器(例如用于人工智能的处理器)与其他用于通信或成像的高度专业化的芯片紧密封装在一起。但世界各地的技术人员都面临着一个重大挑战:如何防止这些芯片堆叠过热。
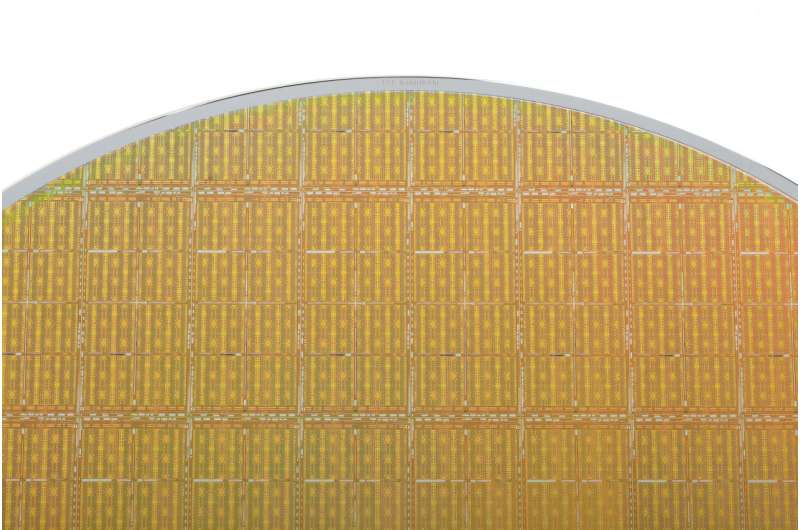
图片来源:MIT
据外媒报道,麻省理工学院(MIT)林肯实验室(Lincoln Laboratory)开发出一种专用芯片,用于测试和验证封装芯片堆叠的冷却解决方案。该芯片功耗极高,模仿高性能逻辑芯片,通过硅层和局部热点产生热量(liàng)。然(rán)后(hòu),随(suí)着(zhe)冷(lěng)却(què)技(jì)术(shù)应(yīng)用(yòng)于(yú)封(fēng)装(zhuāng)芯(xīn)片(piàn)堆(duī)叠(dié),该(gāi)芯(xīn)片(piàn)会(huì)测(cè)量(liàng)温(wēn)度(dù)变(biàn)化(huà)。当(dāng)芯(xīn)片(piàn)被(bèi)夹(jiā)在(zài)芯(xīn)片(piàn)堆(duī)叠(dié)中(zhōng)时(shí),研(yán)究(jiū)人(rén)员(yuán)可(kě)以(yǐ)研(yán)究(jiū)热(rè)量(liàng)如何在芯片堆叠层中移动,并评估保持芯片冷却方面的进展。
“如果只有一块芯片,可以从上方或下方进行冷却。但如果将多个芯片堆叠在一起,热量就无处散发。目前还没有任何冷却方法能够让业界堆叠多个如此高性能的芯片,”研究人员Chenson Chen说道。
Chenson Chen与Ryan Keech共同领导了该芯片的开发,两人都来自林肯实验室的先进材料和微系统组。
这款基准芯片目前正由波音(Boeing)和通用汽车(General Motors)共同拥有的研发公司HRL Laboratories使用,用于开发用于3D异质集成(3DHI)系统的冷却系统。异质集成是指将硅芯片与非硅芯片(例如用于射频(RF)系统的III-V族半导体)堆叠在一起。
 支付宝扫一扫
支付宝扫一扫
 微信扫一扫
微信扫一扫


















